容量トランジエントの測定
DLTS法では、試料温度を連続的に変えながら、各温度において容量トランジエント測定を行うことを基本的手法としています。
DLTS測定における容量トランジエント波形の測定方法を、図A-2および図A-3各図に示しました。
図A-2(a)は、トランジエント測定における電圧印加シーケンス(①~③)を示しています。 図A-2(b)は、それに対応する接合容量の変化を示しています。
また、図A-3では、シーケンスの各段階における試料電極近傍でのバンドプロファイルを示しています。
図A-2 (a)容量トランジエント測定におけるバイアス電圧シーケンスと、(b)対応する試料の接合容量変化
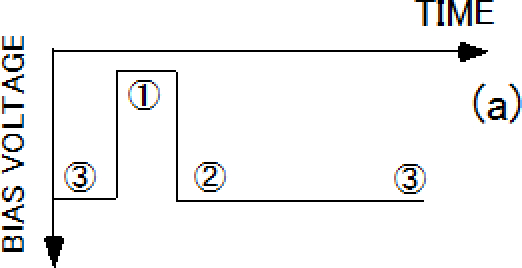
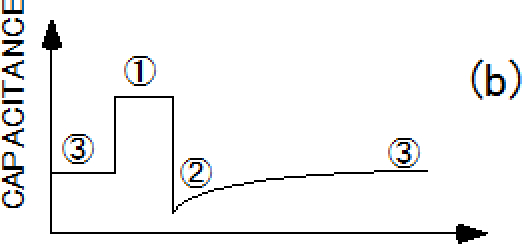
図A-3 図A-2各段階におけるバンドプロファイル
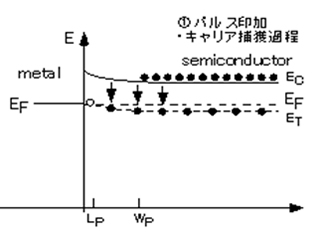
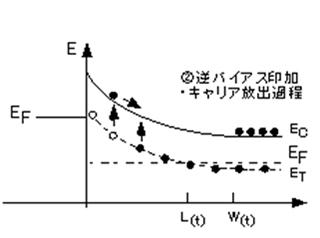
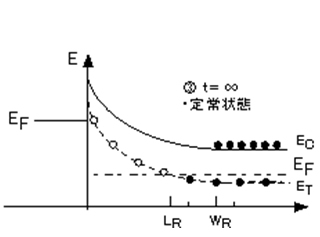
(③)まず最初に、試料には逆バイアス電圧が印加されています。
(①)ここに、順方向の捕獲パルス電圧が印加されますと、バンドプロファイルはほぼフラットバンド状態となり、フェルミ準位(EF)の下(低いエネルギー状態)になった電子トラップ準位(ET)に電子が捕獲されます。
(②)次の瞬間、捕獲パルス印加がoffされますと、EFより上にあるトラップから電子が伝導帯に放出されていきます。電子が放出されたトラップは正に帯電しますので、その電荷をキャンセルするように、空乏層幅が減少(=接合容量の増加)していきます。つまり、電子の放出過程が、接合容量の変化にそのまま反映されることになります。
(③)有限時間の後、電子放出は終了し、系は定常状態(接合容量は一定)となります。
つまり、②の段階における接合容量変化(トランジエント)をモニターすることで、対象とするトラップ準位からの電子の放出過程をとらえることができたことになります。
言い換えますと、このトランジエント波形の時定数には、トラップパラメータ(準位エネルギーと捕獲断面積)に関する情報が、またその振幅には、トラップ濃度に関する情報が含まれています。
したがって、現在のDLTS法は、トランジエントデータを完全に収録し、これに対して種々の数学的手法を駆使して必要な情報の抽出を効率的におこなうものとなっています。 この点に関しては、以下に詳しく述べていきます。
トラップ濃度(NT)が、浅いドナー濃度(NS)に対して、NT<NSの関係を満たす時は、上記の容量トランジエントは指数関数的に変化し、以下の式(A-1)で表されます。

ここで、CR:t=∞における定常容量、△C:全容量変化(トランジエントの振幅)、τe:電子の熱的放出時定数
また、


λ はトラップ準位とフェルミレベルの交差点から空乏層端までの距離であり、空乏層中にありながら、トラップ準位からのキャリア放出が起こらない領域です(図A-3)。
λ は次式(A-20)で与えられます。

ここで、εr:真空の誘電率、ε0:半導体の比誘電率、q:電子の素電荷
もし、トランジエント測定におけるパルス/バイアス電圧を Lp ≈ 0 、λ << WR になるように選んだ場合は、振幅は近似的に

となります。
