DLTS (Deep Level Transient Spectroscopy)
DLTS法とは
DLTS法とは
DLTS法は1974年にLang)によって考案されて以来、さまざまな改良が加えられてきました。
ここでは、まず、「従来法あるいは伝統的DLTS法」としてのLangの手法を詳述し、その後、現在に至る技術の流れにも簡単に触れたいと思います。
DLTS (Deep Level Transient Spectroscopy) 法
半導体材料の特性は、内在するごくわずかな不純物や格子欠陥(結晶欠陥)によって大きく影響を受けるため、それらの評価がたいへん重要となります。
DLTS法は、これら結晶欠陥が作る電子状態(深い準位)を高感度で検出する優れた手法であり、1974年に米国Bell研究所のLangによって考案されて以来、今日に至るまで広く使われてきました。
DLTS法では、その測定原理上、いわゆる半導体接合(ショットキーやpn接合など)を有する試料が使用されます。深い準位に捕獲されたキャリア(たとえば電子)が、バンド(伝導帯)に放出される動的過程を、試料の接合容量の過渡変化を通してモニターすることで、その準位のパラメータ(エネルギーレベル、捕獲断面積)や濃度値、空間的な分布などを知ることができます。

またDLTS法は、単原子レベルの欠陥が作る離散準位の測定だけでなく、MOS構造における界面準位やアモルファス半導体における連続準位の評価にも有力です。
さらにDLTS法の特長として、その優れた感度をあげることができます。
高感度表面分析として知られるSIMS分析での不純物原子検出下限濃度が、10^14 atoms/cm3程度であるのに対して、DLTS法では、条件によっては10^9 atoms/cm3あるいはそれ以下という驚異的な微量濃度の検出が可能です。
(DLTS法に関するより詳細な解説は、別項をご覧ください)
DLTS法、ICTS法などのいわゆる過渡分光法における基礎原理について解説しています。
DLTS/ICTS法は、深い準位からのキャリア放出過程を試料の接合容量の過渡変化を通してモニターするという点において、基本的には同一の測定原理に基づいています。
そのため、以下では、特に両者を比較・対照しない場合は単にDLTSと記載します。
DLTS法は1974年にLang)によって考案されて以来、さまざまな改良が加えられてきました。 ここでは、まず、「従来法あるいは伝統的DLTS法」としてのLangの手法を詳述し、その後、現在に至る技術の流れにも簡単に触れたいと思います。
測定試料
DLTS法においては、その測定原理上、いわゆる半導体接合(ショットキー、pnあるいはMIS構造)を有する試料を必要とします。
したがって、例えばバルク半導体材料中の深い準位を評価する場合には、その表面に金属電極を蒸着するなどしてショットキー接合を、また裏面側にはオーミック電極を形成し、いわばショットキーダイオード構造の試料を作成することになります。
試料が、もともとダイオード構造を有しているデバイスであれば、そのまま測定に供することもできます。
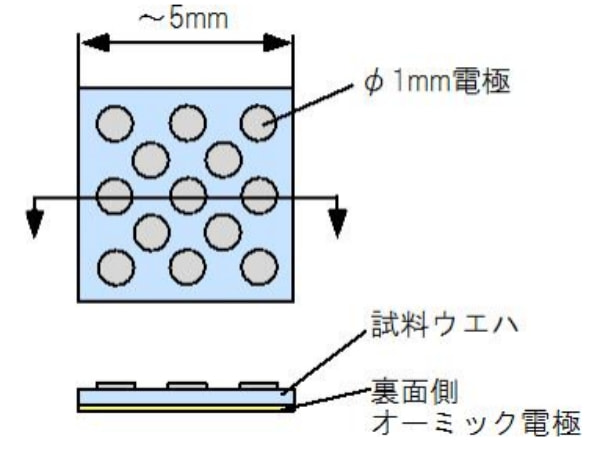
測定原理
ここでは、n型ショットキー接合を持った試料を対象として、その測定原理を説明しますが、pn接合、MIS構造の場合でも、基本原理に変わるところはありません。<原理説明の詳細はこちらから資料ダウンロード>
DLTS測定サービスの特長
セラミックフォーラム株式会社は、DLTS測定サービスを提供しています。DLTSは半導体材料中の重金属不純物原子や結晶欠陥が作る深い準位トラップを検出し、評価を行うための強力な技術です。
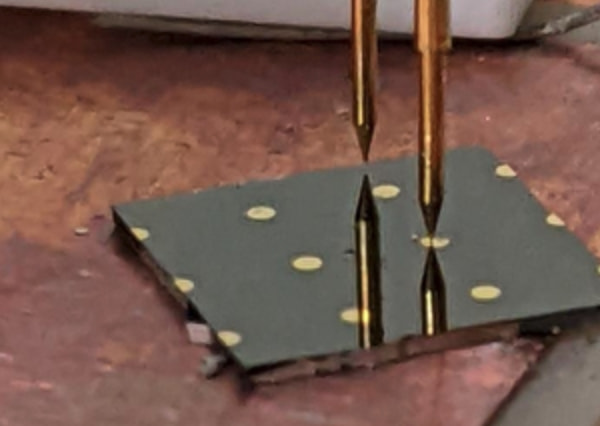
-
高感度な不純物・欠陥検出
高い感度で半導体材料中の不純物や欠陥を検出します。
結晶品質の評価に最適です。
-
先進的な技術と装置
最新のDLTS装置を使用して、正確かつ迅速な測定を行います。
専門的な技術者が測定を担当し、信頼性の高いデータを提供します。
-
幅広い材料対応
Si、GaAsをはじめ、SiC, GaN、ダイヤモンドなどのワイドギャップ半導体まであらゆる半導体材料への適用が可能です。
-
データ解析と報告
測定結果の詳細な解析を行い、わかりやすい報告書を提供します。
データの信頼性と再現性を保証します。
セラミックフォーラム株式会社のDLTS測定サービスは、半導体研究開発を強力にサポートします。詳細な情報やご依頼については、当社までお問い合わせください。


