DLTS测量设备
半导体分析装置DLTS系统 HERA FT1230
DLTS方法是一款高感度测量结晶缺陷导致的电子状态的良好方法。
即便是内在微小的杂质或格子缺陷也会很大程度上影响半导体材料性能,所以此类测量非常重要。DLTS方法是一种通过将深准位捕获的carrier(比如电子)释放于Band带上后,显示其与试料结合容量的过度变化的一种手法,从而可以得知深准位的参数(能量级别、捕获断面积)、浓度值、空间分布等信息。
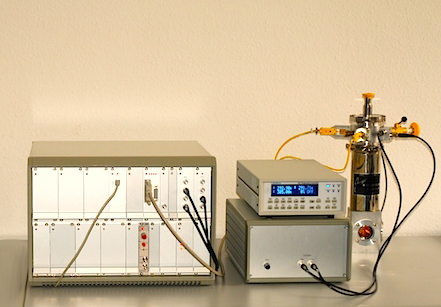
弊司经销的Phystech公司(德国)的DLTS深能级缺陷测量系统(FT1230 HERA-DLTS)不仅装备有最重要的高感度测量系统,还装备有经过精炼改进的对应范围较广的软件,属于可以测量各种特性半导体材料缺陷的高性能测量装置。
FT230除了装备有基本的DLTS测量模式外,还装备有在一定温度下的时间领域测量ICTS(Isothermal Capacitance Transient Spectroscopy)模式。另外,可对应范围包括:使用光脉冲的光DLTS/ICTS、一定容量模式(CC :Constant Capacitance-DLTS)测量、电流模式DLTS/ICTS、再加上对半绝缘性半导体与试料整体的空乏化超薄膜中缺陷评价有效的PITS(Photo-induced current Transient Spectroscopy)法、TSC(Thermally Stimulated Current)法等。电流模式DLTS/ICTS测量也被应用于FET等3端子素子中的缺陷测量。
产品厂家介绍

Phystech公司(德国)
发源于德国Kassel工科大学的DLTS测量装置专业厂家。成功开发出目前在流通的DLTS系统中唯一一款数码对应设备,同时也是世界最普及DLTS系统DL-8000的研发厂家(经销商BIO-RAD)。2016年推出的FT-1230与其他竞争对手的产品相比,拥有更多的测量模式,可对应任何材料及研发人员的需求,属于一款独一无二的扩展性极好的系统。
产品特征
|
HERA-DLTS |
基本DLTS测量 |
|
可测量范围 |
C/V, I/V, C(t) 测量 C/V, I/V, 特性实施 |
|
DLTS测量可选项 |
傅里叶(Fourier)转换 |
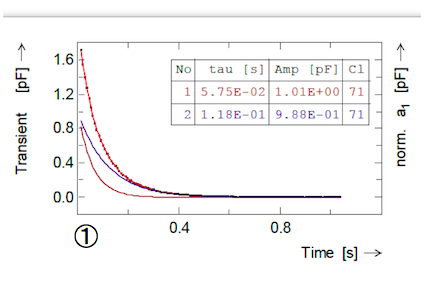
Transient・Data
・测量数据
・Laplace转换后分离的两个时间常数
・重新计算、测量数据比较

ITS Data(一个温度)
- 测量数据
- 重折叠分离
- 重新计算、测量数据比较
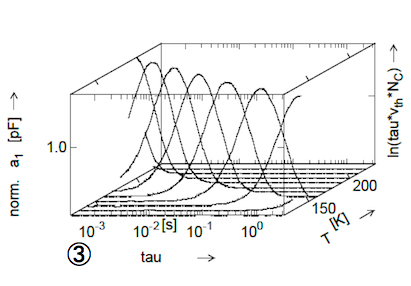
多种温度进行ITS测量
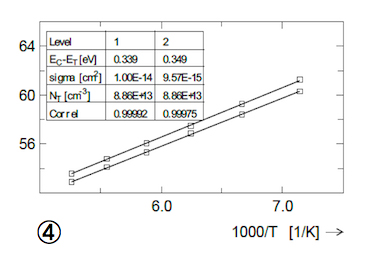
数据2)和3)基础的Arrhenius plot

【Plot1】不同温度"Period width scans"。"Emission time constant"「tau」重新计算的X轴(测量信号)

【Plot2】Plot1的扫描(deconvolution曲线及包含评价时间常数;铅直线)

【Plot3】不指定deconvolution option,直接从Plot1的数据做Arrhenius plot。
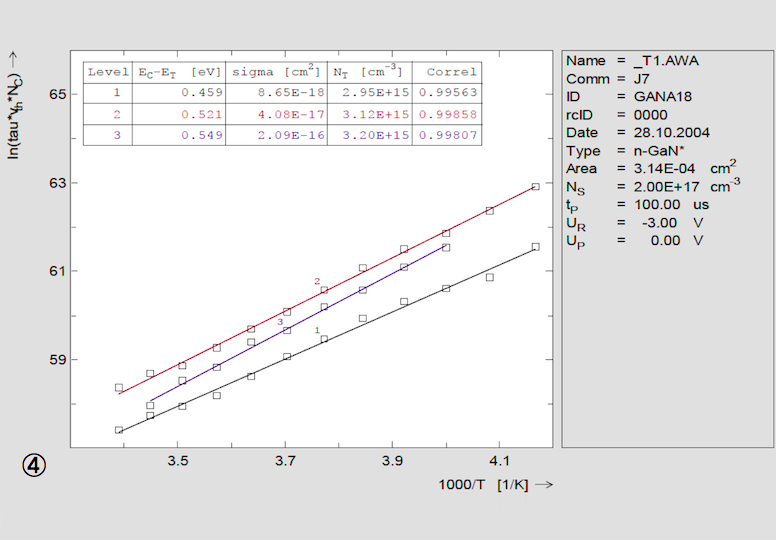
【Plot 4】 利用Plot2的deconvolution数据(1级、2级)的Arrhenius plot。但是,属于与无convolution数据Plot3做的对比。
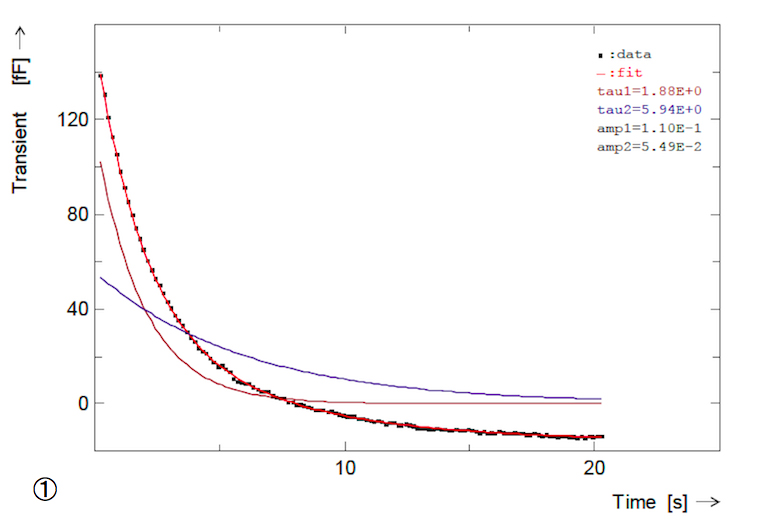
过度Deconvolution:
Multi指数函数过度Fit(Provencher散离、结果非常良好)

Laplace转换(Provencher contain、对于这个过度是不好的结果)
