DLTS法の詳細説明
セラミックフォーラム株式会社 > DLTSについて > DLTS法の詳細説明
ここでは、DLTS法、ICTS法などのいわゆる過渡分光法における基礎原理について解説しています。
DLTS/ICTS法は、深い準位からのキャリア放出過程を試料の接合容量の過渡変化を通してモニターするという点において、基本的には同一の測定原理に基づいています。
そのため、以下では、特に両者を比較・対照しない場合は単にDLTSと記載します。
DLTS法は1974年にLang1)によって考案されて以来、さまざまな改良が加えられてきました。 ここでは、まず、「従来法あるいは伝統的DLTS法」としてのLangの手法を詳述し、その後、現在に至る技術の流れにも簡単に触れたいと思います。
測定試料
DLTS法においては、その測定原理上、いわゆる半導体接合(ショットキー、pnあるいはMIS構造)を有する試料を必要とします。
したがって、例えばバルク半導体材料中の深い準位を評価する場合には、その表面に金属電極を蒸着するなどしてショットキー接合を、また裏面側にはオーミック電極を形成し、いわばショットキーダイオード構造の試料を作成することになります。
試料が、もともとダイオード構造を有しているデバイスであれば、そのまま測定に供することもできます。
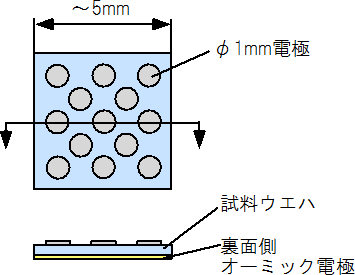
測定原理
ここでは、n型ショットキー接合を持った試料を対象として、その測定原理を説明しますが、pn接合、MIS構造の場合でも、基本原理に変わるところはありません。
●参考文献
1) D. V. Lang, J. Appl. Phys. 45, 3023 (1974).
