受託評価・解析サービス
セラミックフォーラム(株)では、 DLTS (Deep Level Transient Spectroscopy)法による半導体材料/デバイス中の欠陥評価に関する受託測定・解析サービスを開始しました。
DLTS法は、半導体中の欠陥評価法としては、その検出感度などにおいて他の分析手段では得られないメリットを有します。
しかしながら、これを使いこなして、適格な評価結果を得るためには、相当の知識・経験が必要であることも事実です。
当社では、装置システム販売とともに、受託測定・解析サービスを通して、DLTS関連技術のさらなる普及を促し、微力ながら、我が国における半導体産業の発展に貢献したいと考えております。
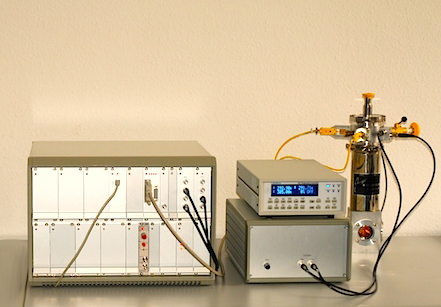
当社受託測定・解析サービスの特長
(1)幅広い測定ニーズに対応可能
DLTS法は確かに高感度な測定手段ではありますが、対象とする半導体物性は多様です。
たとえば、いわゆる半絶縁性半導体や空乏層が試料全体におよぶ極薄膜半導体では、もはや接合容量の過渡変化を測定することはできず、通常の容量DLTS法は無力となります。
このような試料に対しては、電流モードを基本とするPITS法やTSC法が有効となります。
当社では、FT1030測定システムを基本系とし、試料の物性に応じた幅広い測定ニーズに対応可能です。
(2)専門技術者による対応
当社受託測定・解析サービスを担当するのは、長年、半導体材料の研究開発、DLTS法による欠陥評価を経験してきた専門技術者です。
欠陥準位はその準安定的挙動など、しばしば複雑な現象を示すことがあり、DLTS測定結果の解釈が困難となる場合が少なくありません。
豊富な知識・経験を有する当社スタッフが問題を解決いたします。
当社受託測定・解析サービスの特長
図1.SiCエピ層のDLTSスペクトル

図2.SiC-MOS界面準位の評価(DLTS/CC-DLTSの比較)
通常のDLTS法では、界面準位濃度を過大評価(Δ=28%, @0.5eV)していることがわかります。
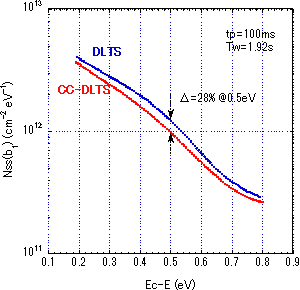
図3.半絶縁性GaAsのPITSスペクトル
T1~7で示された7個の準位の存在が示されています。

