Phystech社DLTS測定装置(FT1030)
当社が販売するPhystech社(独)のDLTS測定装置(FT1030 HERA-DLTS)は、DLTS測定において最も必要とされる高感度な測定系に加え、種々の特性を有する半導体材料の欠陥評価に対し幅広く対応できる洗練されたソフトウエアを備えた高機能測定装置です。
FT1030によるDLTS測定モード
FT1030では、基本DLTS測定モードに加えて、一定温度下での時間ドメイン測定としてのICTS(Isothermal Capacitance Transient Spectroscopy)モードを備えています。
また、光パルスを用いた光DLTS/ICTS、一定容量モード(CC :Constant Capacitance-DLTS)測定、電流モードDLTS/ICTS、さらに半絶縁性半導体や試料全体が空乏化する極薄膜中の欠陥評価に有効なPITS(Photo-induced current Transient Spectroscopy)法、TSC(Thermally Stimulated Current)法などの測定にも対応できます。
電流モードDLTS/ICTS測定は、FETなど3端子素子中の欠陥評価にも応用されます。
これらの詳細は下表をご覧ください。
FT1030によるDLTS測定モード
スクロールで図全体をご覧いただけます。
| 測定方法 (モード) |
捕獲パルス /測定物理量 |
特長とアプリケーション |
|---|---|---|
| ①DLTS | 電圧/容量 | ☆ DLTSにおける基本的測定モード。欠陥準位のエネルギーレベル、捕獲断面積および濃度を最も高感度に測定できる。 ・離散準位のみならず、MIS界面準位、アモルファス半導体中の連続準位の評価にも適用可能 |
| ②I-DLTS/ICTS (Current-) |
電圧/電流 | ☆ 深い準位からのキャリア放出過程を、過渡電流としてモニターする。 ・キャリア放出過程において完全空乏化する極薄膜半導体試料での評価に有効 |
| ③CC-DLTS/ICTS (Constant Capacitance-) | 電圧/電圧 | ☆ キャリア放出過程での容量が一定(空乏層幅が一定)になるようにバイアス電圧にフィードバックをかけるため、測定領域が一定に保持される。 ・トラップ濃度が非常に高い試料での濃度定量性が良好 ・キャリア放出過程において完全空乏化する極薄膜半導体試料での評価 ・MIS界面準位密度プロファイルの精密な測定が可能 |
| ④D-DLTS (Double correlation-) |
電圧/容量 | ☆ 2つの異なるバイアス電圧における容量トランジエント波形の差測定から、空間的局所領域の情報を得る。 ・欠陥濃度の深さ方向分布の測定 ・キャリア放出過程に及ぼす局所電界効果(Poole-Frenkel効果)の評価 |
| ⑤O-DLTS (Optical-) |
光/容量 | ☆ キャリア捕獲過程を光パルス印加により行う。 ・ショットキー接合試料での少数キャリアトラップの評価が可能 ・欠陥準位における光学的パラメータ(光イオン化断面積など)の評価 |
| ⑥ICTS (Isothermal Capacitance Transient Spectroscopy) |
― | ☆ 一定温度下、時間ドメインでの過渡容量測定。①~⑤と同様の測定の適用が可能。測定温度によって大きな物性変化がある場合などに有効 ・アモルファス半導体中の欠陥評価など |
| ⑦PITS (Photo-induced current Transient Spectroscopy) |
光/電流 | ☆ 光パルスを用いたI-DLTS測定と等価。 ・容量の過渡変化を測定することができない半絶縁性半導体試料中の欠陥評価 ・キャリア放出過程において完全空乏化する極薄膜半導体試料での評価 |
| ⑧TSC/TSCAP (Thermally Stimulated Current/Capacitance) |
電圧、光 /電流、容量 |
☆ これらは過渡変化測定ではなく、定常モードでの測定。低温下においてキャリアを捕獲させた試料を一定速度で昇温し、キャリア放出過程を電流、または接合容量変化としてとらえる。 ・適用例は、PITSと同様。TSCに関しては、半導体以外の絶縁材料(イオン結晶、樹脂、ガラス)や粉体などに関する電荷現象の研究にも幅広く適用可能 |
| ⑨FET Characterization | 電圧 /容量、電流 |
☆ FETなど3端子素子中の欠陥を直接的に測定する方法。 ・異なるSD電圧下でのゲート容量のDLTS測定、または異なるゲート電圧下でのドレイン電流のI-DLTS測定により、ゲート絶縁膜近傍や活性層中のトラップ濃度を評価可能 |
FT1030では、上記のほか、トラップ濃度プロファイル測定、捕獲パルス法による捕獲断面積の直接測定、Zerbst解析など種々の測定アプリケーションを備えています。
DLTS測定装置において最も重要な性能項目の一つは感度です。FT1030では、独自に工夫されたハードウエア/ソフトウエアを有し、その結果として、以下のような高感度を有します。
・容量計の感度:0.01 fF
・トラップ検出感度:10-7
FT1030では、上記のほか、トラップ濃度プロファイル測定、捕獲パルス法による捕獲断面積の直接測定、Zerbst解析など種々の測定アプリケーションを備えています。
DLTS測定装置において最も重要な性能項目の一つは感度です。FT1030では、独自に工夫されたハードウエア/ソフトウエアを有し、その結果として、以下のような高感度を有します。
・容量計の感度:0.01 fF
・トラップ検出感度:10-7
FT1030のもう一つの特長は、HERA(High Energy Resolution Analysis)-DLTSシステムにあります。
DLTSスペクトルは、通常、比較的ブロードな形状を有します。
仮にエネルギーが近接した二つの準位が存在する場合、従来のDLTS法でそれらを分離することは容易ではありませんでした。
これに対してHERA-DLTSシステムでは、いくつかの新しい数学アルゴリズム(Provencher contin and discrete; www. s-provenchre.com)を使った近接波形分離ソフトウエアにより高いエネルギー分解能を実現しました。
それらは、フーリエ変換、ラプラス変換、マルチ指数関数フィッティングおよびICTSスペクトルおよびDLTSスペクトルのデコンボリューションなどから構成されています。以下にそれらの使用例を示します。
HERA解析においては、容量(または電流、電圧)トランジエント波形に対して、あるいはDLTS/ICTSスペクトルに対して、という二つの適用方法があります。
図1は、ある温度における深い準位からのキャリア放出過程に対応する容量トランジエント波形に対して、ラプラス変換法を適用し、二つの指数関数的なキャリア放出過程を分離抽出するシミュレーション例を示しています。
また、図2では、ICTSスペクトルに対して、HERA解析を適用することで、近接した熱的放出時定数を有する二つの準位を分離抽出する例を示しています。6点の異なる温度における同様な測定(図3)から、分離したそれぞれの準位における熱的放出時定数の温度変化を求め、これをアレニウスプロット(図4)することで、近接した各準位のエネルギー、捕獲断面積、濃度を解析することができます。
シミュレーションデータ:
E1=0.34eV, E2=0.35eV, σ1,2=1.0E-14cm2, Amplitude1,2=1.0pF
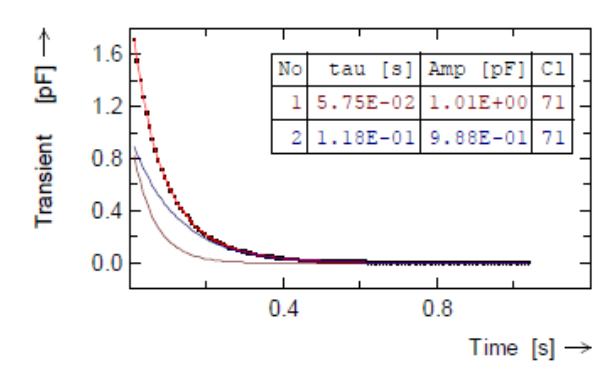
図1.容量トランジエント波形のラプラス変換による分離 (○:データ点、赤紫実線(1)および青実線(2):分離した各トランジエント、赤実線:フィッティング結果)

図2.HERA解析によるICTSスペクトル(a1)における近接ピークの分離
(□:データ点、緑:デコンボリューションによって分離されたピーク、赤:フィッティング結果)
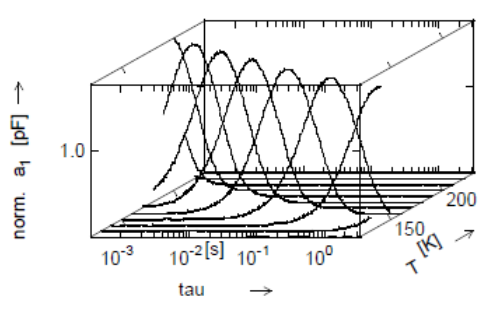
図3.6つの温度条件におけるICTSスペクトル
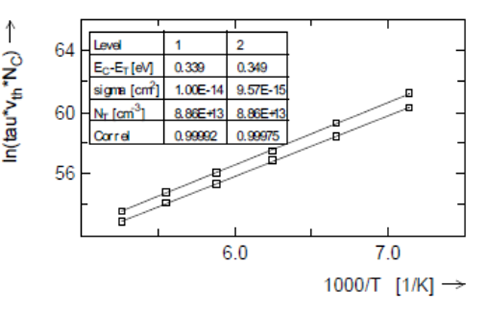
図4.図2および図3のデータによるアレニウスプロット
DLTSスペクトルに対するHERAデコンボリューションの例を図5に示しました。
このスペクトルでは、a1(cosineの相関関数)による解析を行っていますが、2個の近接準位について、それぞれ1組の熱的放出時定数と温度の関係が求まったことになります。

図5.HERA解析によるDLTSスペクトル(a1)における近接ピークの分離
(□:データ点、緑:デコンボリューションによって分離されたピーク、赤:フィッティング結果)
同様な解析を、23種類の相関関数について行い、得られた結果をアレニウスプロットしたもの(Maximum analysis)が、図6です。
図中には、近接2準位に対するパラメータおよび濃度の解析結果を示しています。

図6. 図5と同様の解析を23個の相関関数について行い、得られた結果をアレニウスプロットしたもの(Maximum analysis
以上のように、PhysTech社のHERA-DLTS:FT1030は、新しい数学アルゴリズムによる高精度、高分解能な基本性能に加えて、欠陥評価において求められるきわめて多様な応用解析ソフトウエアを具備した高機能性欠陥評価解析システムです。
