DLTS法とは
セラミックフォーラム株式会社 > DLTSについて > DLTS法とは
DLTS (Deep Level Transient Spectroscopy) 法
半導体材料の特性は、内在するごくわずかな不純物や格子欠陥(結晶欠陥)によって大きく影響を受けるため、それらの評価がたいへん重要となります。
DLTS法は、これら結晶欠陥が作る電子状態(深い準位)を高感度で検出する優れた手法であり、1974年に米国Bell研究所のLangによって考案されて以来、今日に至るまで広く使われてきました。
DLTS法では、その測定原理上、いわゆる半導体接合(ショットキーやpn接合など)を有する試料が使用されます。深い準位に捕獲されたキャリア(たとえば電子)が、バンド(伝導帯)に放出される動的過程を、試料の接合容量の過渡変化を通してモニターすることで、その準位のパラメータ(エネルギーレベル、捕獲断面積)や濃度値、空間的な分布などを知ることができます。
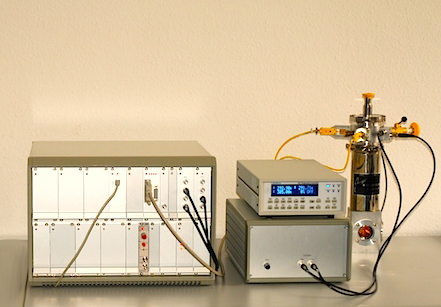
またDLTS法は、単原子レベルの欠陥が作る離散準位の測定だけでなく、MOS構造における界面準位やアモルファス半導体における連続準位の評価にも有力です。
さらにDLTS法の特長として、その優れた感度をあげることができます。
高感度表面分析として知られるSIMS分析での不純物原子検出下限濃度が、1014 atoms/cm3程度であるのに対して、DLTS法では、条件によっては109 atoms/cm3あるいはそれ以下という驚異的な微量濃度の検出が可能です。
(DLTS法に関するより詳細な解説は、別項をご覧ください)
